在TOF-SIMS數據的解析過程中,通常需要將實測二次離子的質荷比與標準數據庫中記錄的原子離子或分子離子的精確質量數進行比對,以確定二次離子所對應的元素或分子結構。因此,準確的質量校準是TOF-SIMS數據處理中至關重要的一步。本期技術文章將介紹如何正確進行TOF-SIMS數據的質量校準。
TOF-SIMS質量校準原理
在TOF-SIMS分析中,質譜儀記錄的原始信號為二次離子到達探測器所用的飛行時間及其信號強度。二次離子的質荷比是根據其飛行時間計算得出的。這一轉換過程通常由采集軟件自動完成,但原始數據中的譜峰位置可能存在偏差。若直接使用原始數據中的質荷比,將影響后續的譜峰識別。因此,在解析譜圖之前,需對二次離子的質荷比進行校準,該過程稱為質量校準(mass calibration)。
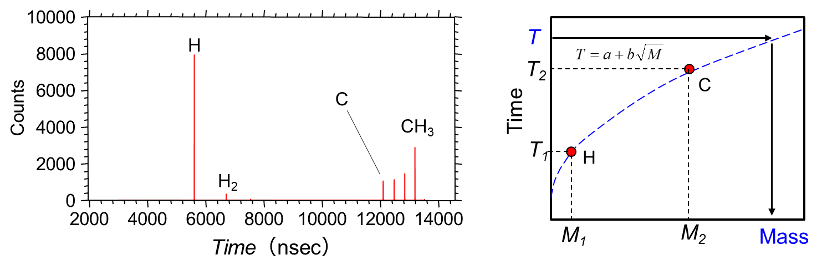 圖1. TOF-SIMS質量校準原理
圖1. TOF-SIMS質量校準原理
* 由于多價態二次離子難以脫離樣品表面束縛進入質量分析器,TOF-SIMS分析過程中主要檢測帶一個單位正/負電荷的二次離子,因此,在解析數據時可將二次離子質荷比簡稱為二次離子質量。
圖1展示了質量校準的基本原理與主要流程。質量數為M的二次離子在質譜儀中的總飛行時間T由兩部分組成:一次離子到達樣品表面的時間,以及二次離子從樣品表面飛行至探測器的時間。前者由一次離子類型和加速電壓決定,后者與二次離子質量M的平方根成正比,兩者之間滿足以下關系:

式中,a和b是兩個常數。若已知兩個二次離子的質量M及其對應的飛行時間T,即可通過最小二乘法擬合出a和b的值,從而建立任意二次離子飛行時間與質量數之間的關系。由于飛行時間與質量數之間為非線性關系,為減小校準偏差并提高質量精度,實際操作中通常需選用三個及以上已知離子對譜圖進行校準。
質量校準的基本原則
在使用TOF-SIMS數據處理軟件進行校準時,程序會根據所選校準譜峰自動完成上述計算,但需遵循以下基本原則以確保校準準確:
?只能用已經知道分子式/元素的質譜峰來進行質量校準;
?至少需要使用三個非H的質譜峰來校準譜圖;
?優先選擇質量數較大,分布均勻的譜峰;
?校準后各校準質譜峰的質量偏差應小于100 ppm。
國際標準ISO 13084:2018對TOF-SIMS數據質量校準提出更為具體的要求,被視為TOF-SIMS 領域 “質量標尺校準的基準方法” [1],主要內容包括:
?由于樣品表面粗糙度會影響質量分辨率,當樣品表面粗糙度大于1 μm時,質量校準精度會變差;
?不建議使用氫離子進行校準,因為氫離子飛行時間受磁場干擾較大
?識別分子離子時,避免使用原子離子進行校準;
?最大校準峰的質量數應超過所分析譜峰質量的55%(例如識別1000 amu的譜峰時,應使用高于550 amu的校準峰);
?校準譜峰數量并不是越多越好,應控制在5個以內。
校準譜峰選擇
在校準時,我們需要結合樣品成分信息,選擇合適的譜峰對數據進行質量校準。通常在大部分樣品表面都會檢測到碳氫化合物的信號,這類物質極易吸附在樣品表面,且二次離子產額較高,因此,在大部分情況下,推薦使用碳氫化合物系列譜峰對TOF-SIMS數據進行校準:
?正離子模式下:CH3+/C2H3+/C3H5+/C4H7+等
?負離子模式下:CH-/C2H-/C4H-/C6H-等
當然,并不是所有的數據都可以使用碳氫化合物系列譜峰進行校準,當這類組分信號比較弱時,也可以選擇信號較強的特征二次離子峰來進行質量校準。例如,在循環后的鋰電材料通常會檢測到較強的LiF類組分信號(正離子模式下:Li2F+/Li3F2+/Li4F3+等;負離子模式下:LiF2-/Li2F3-/Li4F3-等),這時也可以用這類譜峰進行校準。此外,一些樣品表面容易電離的污染物組分,如堿金屬離子(Li+/Na+/K+/Cs+)和鹵族組分(F-/Cl-/Br-/I-),也可以用于質量校準。
另外,同一個樣品的校準譜峰也不是一成不變的。樣品需同時進行表面分析和深度分析,且成分隨深度變化,則表面譜與深度累積譜可能需采用不同的校準峰,應根據實際成分和譜圖特征靈活調整。
軟件操作:TOF-DR質量校準步驟
TOF-SIMS數據通常需要使用專用的數據處理軟件來進行質量校準,圖2展示了PHI TOF-SIMS數據處理軟件TOF-DR的質量校準界面與操作流程:
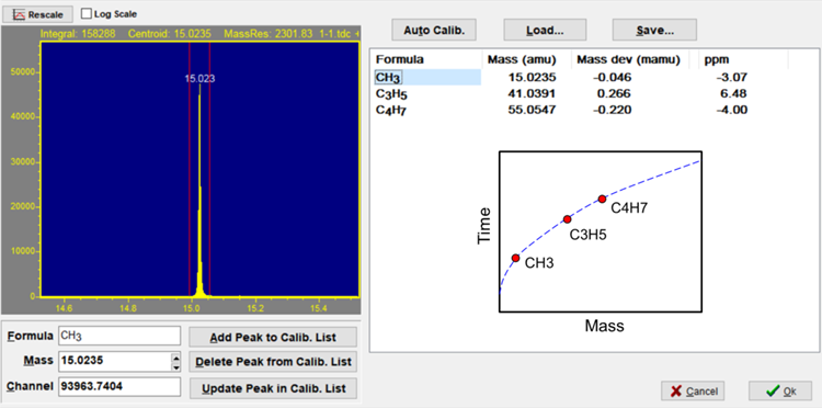
圖2. TOF-DR質量校準界面
1.打開待校準的質譜數據,點擊“Calibrate”按鈕,進入如圖所示的校準界面;
2.添加/刪除校準譜峰
·添加:在“Formula”一欄中輸入想要添加的二次離子化學式,并以空格或“+”隔開元素,之后點擊“Add Peak to Calib. List”按鈕;例如,添加C4H7+時,請輸入C4+H7;
·刪除:在界面右側選中想要刪除的譜峰,并點擊“Delete Peak from Calib. List”按鈕進行刪除;
3.確認校準譜峰位置
·在界面右側選中待校準譜峰,使用雙光標調整校準列表中每個譜峰的左右兩側積分區間,逐個確定譜峰位置是否正確,并按下“Update Peak in Calib. List”按鈕;
4.評估校準結果
在確認每個校準譜峰的峰位置與積分區間后,軟件會自動計算校準后的譜峰偏差,并顯示校準結果。圖2右側展示的是質量校準的相關參數,分別為:
? Formula:校準譜峰;
? Mass (amu):校準譜峰的實測質量值;
? Mass dev (mamu):校準譜峰實測質量值與理論值的絕對偏差,單位mamu;
? ppm:校準譜峰實測質量值與理論值的相對偏差,即絕對偏差/譜峰理論精確質量,單位ppm。
在完成步驟1-3之后,我們需要根據質量偏差評估校準結果是否達標。對于表面平整的樣品,通常我們會選擇質量數小于100 amu的3個譜峰進行校準,校準后絕對質量偏差應小于1 mamu,相對質量偏差應小于100 ppm。
但在實際測試中,這個評價標準并非絕對的。對于表面凹凸不平或導電性較差、測試過程荷電效應較為嚴重的樣品,所采集的質譜數據質量分辨率通常較差,譜峰拖尾也會比較嚴重,這時即使我們做了正確的質量校準,校準后的質量偏差也很難控制在1 mamu和100 ppm以內。在分析這類校準后質量偏差較大的質譜數據時,不能完全依賴于數據庫質量數比對來解析譜峰,需要結合譜峰出峰規律、同位素豐度比以及其他輔助信息來進行譜峰識別。
小結
質量校準是TOF-SIMS數據處理中的關鍵步驟,校準準確性直接影響譜峰識別的可靠性,但是錯誤校準將導致后續解析失敗。因此,TOF-SMS數據分析時須嚴格遵循規范流程,確保校準準確,為深入的數據分析奠定堅實基礎。
參考文獻
[1] ISO 13084:2018 Surface chemical analysis — Secondary-ion mass spectrometry — Calibration of the mass scale for a time-of-flight secondary-ion mass spectrometer [S]. Geneva: International Organization for Standardization, 2018.